Los investigadores del instituto de investigación CEA-Leti han presentado los avances de la integración de tres capas para permitir una nueva generación de sensores de imagen CMOS (CIS) que puedan explotar todos los datos de la imagen para percibir una escena, comprender la situación e intervenir en ella. Estas capacidades requieren incorporar la inteligencia artificial (IA) en el sensor.
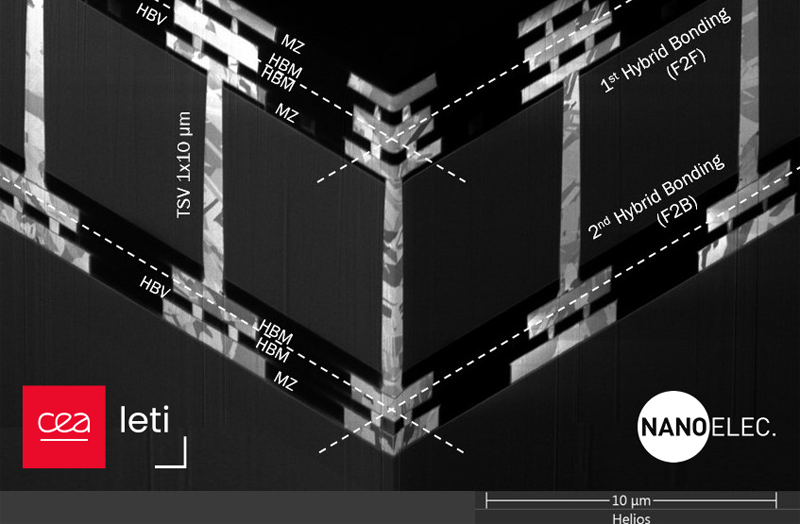
La demanda de sensores inteligentes está creciendo rápidamente debido a sus capacidades de generación de imágenes de alto rendimiento en teléfonos inteligentes, cámaras digitales, automóviles y dispositivos médicos. Esta demanda de calidad de imagen y funcionalidad mejorada por IA integrada ha presentado a los fabricantes el desafío de mejorar el rendimiento del sensor sin aumentar el tamaño del dispositivo.
A esto se le añade apilar múltiples troqueles para crear arquitecturas 3D, como generadores de imágenes de tres capas, que ha llevado a un cambio de paradigma en el diseño de sensores. La comunicación entre los diferentes niveles requiere tecnologías de interconexión avanzadas, un requisito que cumple el enlace híbrido debido a su paso muy fino en el rango micrométrico e incluso submicrométrico. Asimismo, la alta densidad a través del silicio (HD TSV) a una densidad similar permite la transmisión de señales a través de los niveles intermedios. Ambas tecnologías contribuyen a la reducción de la longitud del cable, un factor crítico para mejorar el rendimiento de las arquitecturas apiladas en 3D.
La combinación de enlaces híbridos con HD TSV en sensores de imagen CMOS podría facilitar la integración de varios componentes, como conjuntos de sensores de imagen, circuitos de procesamiento de señales y elementos de memoria, con una precisión y compacidad incomparables.
Vehículo de pruebas de tres capas
El proyecto desarrolló un vehículo de prueba de tres capas que incluía dos interfaces de enlace híbrido Cu-Cu integradas, cara a cara (F2F) y cara a espalda (F2B), y con una oblea que contenía TSV de alta densidad. Según los investigadores, el vehículo de prueba es un hito clave porque demuestra tanto la viabilidad de cada bloque tecnológico como la viabilidad del flujo del proceso de integración.
El vehículo de prueba desarrollado es de dos capas que combina un HD TSV de 10 micras de alto y 1 micra de diámetro y una tecnología de unión híbrida altamente controlada, ambos ensamblados en configuración F2B. Los investigadores mejoraron este vehículo de prueba acortando el HD TSV a seis micras de alto, lo que condujo al desarrollo de un vehículo de prueba de dos capas que exhibe un rendimiento eléctrico de baja dispersión y permite una fabricación más simple.
Esta altura reducida provocó una disminución del 40% en la resistencia eléctrica, en proporción a la reducción de la longitud. La reducción simultánea de la relación de aspecto aumentó la cobertura del paso del revestimiento aislante, lo que llevó a una mejor resistencia al voltaje.
Gracias a este vehículo de pruebas, se han podido desarrollar nuevos generadores de imágenes inteligentes multicapa 3D con IA de borde implementada en el propio sensor, que supondrán un gran avance en el campo de las imágenes, porque la inteligencia artificial de borde aumentará el rendimiento de los generadores de imágenes y permitirá nuevas aplicaciones.